 Согласно недавнему отчету тайваньского издания Commercial Times, опубликованному на EE Times, а также отдельному исследовательскому отчету от Мин-Чи Куо из KGI Securities, тайваньская компания TSMC, возможно, получила эксклюзивные права на производство чипа A10, предназначенного для iPhone 7 следующего поколения.
Согласно недавнему отчету тайваньского издания Commercial Times, опубликованному на EE Times, а также отдельному исследовательскому отчету от Мин-Чи Куо из KGI Securities, тайваньская компания TSMC, возможно, получила эксклюзивные права на производство чипа A10, предназначенного для iPhone 7 следующего поколения.
Это отличается от разделенного производства процессора A9 между Samsung и TSMC, которое использовалось в iPhone 6s и iPhone 6s Plus. Решение Apple вернуться к TSMC в качестве единственного поставщика, как это было при производстве чипа A8, может быть обусловлено передовыми технологиями корпусирования устройств, предлагаемыми TSMC, которые могут отсутствовать у Samsung.
В отчете Commercial Times упоминается технология TSMC InFO WLP (integrated fan-out wafer-level packaging) как одна из ключевых особенностей производственного контракта. InFO WLP — одна из многих конкурирующих 3D IC технологий, которые обещают более высокую степень интеграции компонентов в одном корпусе с лучшими электрическими характеристиками.
Среди этих усовершенствований — возможность использования шин памяти большей ширины, поддерживающих работу с низким энергопотреблением, что необходимо для мобильных устройств и, для потребителей, означает лучшую производительность и эффективность. Технологии 3D IC только начинают появляться в потребительском сегменте, и использование AMD High Bandwidth Memory (HBM) в линейке дискретных видеокарт Fiji XT является одним из первых примеров.
Согласно тезисам статьи инженеров TSMC, InFO WLP также обеспечивает лучшую тепловую производительность, а также превосходную производительность для радиочастотных (RF) компонентов, таких как сотовые модемы. В прошлом году мы сообщали о том, что Apple нанимает больше инженеров для потенциального переноса разработки RF-компонентов внутрь компании, поэтому эта технология корпусирования может служить дополнительной мотивацией для Apple в плане корпусирования в будущем. Даже если бы Samsung могла предложить Apple сопоставимую технологию, сложности с проверкой дизайна на двух новых производственных линиях могли бы стать мотивирующим фактором для Apple в выборе одного поставщика для своего следующего процессора.
В ближайшей перспективе тепловые преимущества и потенциальное увеличение пропускной способности памяти являются более непосредственными источниками улучшения для следующего чипа Apple. Многие технологии 3D IC сталкивались с медленным внедрением из-за увеличения затрат и этапов обработки, но более простая технология InFO WLP предлагает Apple более легкий и дешевый входной пункт, к тому же Apple имеет роскошь необычно высокой маржи на своих устройствах.
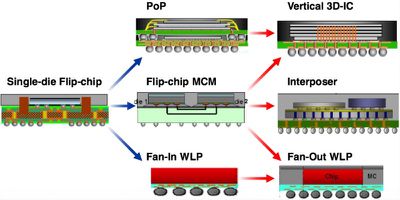
InFO WLP от TSMC отличается от многих конкурирующих 3D IC решений тем, что не требует дополнительного кремниевого интерпозера наряду с существующей подложкой корпуса, используемой для интеграции компонентов. Хотя они и не содержат активных компонентов, кремниевые интерпозеры изготавливаются на кремниевых пластинах, как и процессоры приложений, используемые в мобильных устройствах, что делает их дорогостоящим дополнением к сборке устройства.
InFO WLP позволяет располагать несколько компонентов типа «flip-chip» рядом друг с другом на подложке корпуса, напоминающей традиционную сборку, но с возможностью их электрического соединения через подложку корпуса. Это отличается от традиционных методов, которые включают штабелируемые корпуса (package on package, или PoP), соединенные крошечными проводами. По мере развития мобильных технологий памяти, последней итерацией которых является LPDDR4, электрическая сигнализация становится все более сложной технической задачей, что делает технологии 3D IC более привлекательными для повышения производительности.
Список включенных компонентов не ограничивался бы только памятью, поэтому будущие разборки устройств будут интересны по мере того, как мобильные устройства начнут включать эти технологии. Больше информации о технологиях корпусирования TSMC можно найти в этом PDF.


















